隱形切割加工


聯絡旭丞
236 新北市土城區永豐路173之8號1樓
TEL: +886-2-2262-6589
FAX: +886-2-2262-6585
vanessa_lin@uvtech.com.tw
南部窗口銷售業務:
TEL: +886-905-786-031
TEL: +886-2-2262-6589
FAX: +886-2-2262-6585
vanessa_lin@uvtech.com.tw
南部窗口銷售業務:
TEL: +886-905-786-031
隱形切割加工
隱形切割技術(Stealth Dicing)是一種在晶圓內部應用雷射進行切割的方法。它是為了解決傳統機械切割在晶圓輕薄化趨勢下所遇到的困難而開發的一種先進的切割技術。
在隱形切割技術中,雷射光束聚焦在晶圓內部的特定位置,通過高能量密度使晶圓內部材料發生變質,形成一個稱為"變質層"的區域。接著,通過使用擴展膠膜等方法,將晶圓分割成多個晶片,每個晶片都具有自己的變質層。
隱形切割技術具有一些優點。首先,它是一種非接觸式的切割方法,避免了機械接觸可能對晶圓造成的損傷。其次,由於雷射光束可以精確控制和定位,因此可以實現高精度的切割。此外,隱形雷射晶圓切割技術還具有較低的熱影響和較少的殘留應力,可以提高晶片的品質和可靠性。
在半導體製造中,隱形雷射晶圓切割技術不僅可以用於晶圓的切割,還可以應用於其他工序,如半導體的薄化、裁剪和封裝等。此外,隨著半導體行業對3D積層技術的需求增加,利用矽通孔配線(TSV)進行3D積層的開發也正在不斷進展中,這將進一步促進隱形雷射晶圓切割技術的應用。
隱形雷射晶圓切割技術代表了半導體製造中切割方法的一個重要進步,可以幫助實現更高性能和更高集積度的半導體元件。

▲上圖為玻璃基板 厚度0.2~0.4T 隱形雷射切割 (包含裂片與5吋擴張製程)
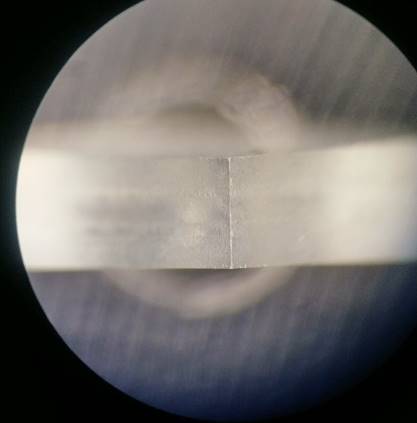
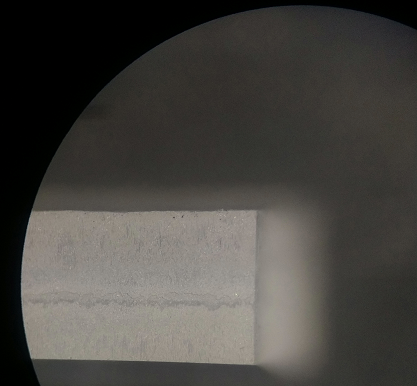
▲上圖為 隱形切割 斷面圖 2.5T ,材質 玻璃 / 石英






 產品展示
產品展示 